- 製品名やキーワードで検索
- お電話でのお問い合わせはこちら
-
東京03-5379-0051 大阪06-6212-2500
名古屋052-686-4794 仙台022-218-0560
- 製品名やキーワードで検索
東京03-5379-0051 大阪06-6212-2500
名古屋052-686-4794 仙台022-218-0560

特許取得(米国特許番号:9,354,118)の新MWE(Multi-Wavelength Ellipsometer)技術とマルチ波長のLED光源を使用することで、
ワイドなスペクトルを持つエリプソメトリー解析が可能です。
更に新しくリリースされたFS-1(G3)とFS-1EXはそれぞれ赤外領域と紫外領域のLEDを追加してより広い範囲で、強化された薄膜測定を提供します。FS-1光源ユニットの光学経路は、マルチスペクトルのLED光源を明るく均一な1筋の光へと統合されます。
FS-1の主な機能と特長は下表の通りです。
| 主な機能 | 特長 |
|---|---|
| マルチLED光源 (405~950nmの波長範囲から4もしくは6つの光源) |
長寿命(50,000時間以上)で、装置のご利用期間中にLED光源やそれに伴う光軸校正をする必要はありません |
| 特許取得のMWE技術により、検出器に可動部位なし | 分光エリプソ以上の高い再現性精度を実現 最短10ミリ秒の高速測定が可能 分光エリプソに必要な定期的な校正は不要 |
| 高い再現性精度を実現 |
精度は、多くのサンプルで0.01nmを超えます (測定時間1秒の場合) |
| PCを内蔵しWebブラウザから制御可能 | 複雑なソフトウェアのセットアップやメンテナンスが不要 |
新しくリリースされたFS-1(G3)およびFS-1EXは、より多くの波長とより広いスペクトル範囲で、強化された薄膜測定を提供します。 新しいシステムは、使いやすさと手頃な価格を維持しながら、特許取得済のMWE(Multi-Wavelength Ellipsometer)技術と長寿命LED光源、高速でかつ高い再現性を実現した可動部のない検出器、コンパクトデザイン、Webブラウザーインターフェイスを提供します。
| 品名 | 【NEW】FS-1(G3) | 【NEW】FS-1EX |
|---|---|---|
| スペクトル範囲 | 450 - 660 nm | 405 - 950 nm |
| 波長域 | 4 | 6 |
| 特長 |
・厚さ0 Å~2 μ mの透明膜を0.001nmの精度で測定可能 ・ 再現性精度が2倍向上(従来装置との比較) ・ 簡単に in situ 測定可能 ・ 光源と検出器がそれぞれ110×80×60mmのコンパクト設計 |
・ 850および950nmの長い波長により、最大5μmの透明フィルムの測定、poly-Si、SiGe、アモルファス Si などの半導体フィルムの測定が可能。 ・ 多層膜の測定機能が向上しました。 |
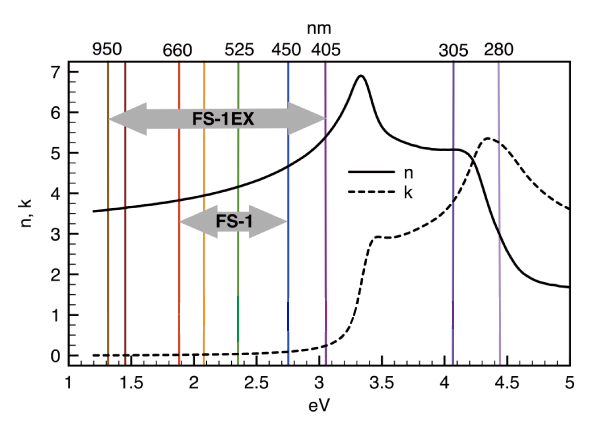

エリプソメーターは薄膜に対して非常に高感度です。これはエリプソメトリックな(Δ:デルタ)パラメーターに由来しています。エリプソメーターは、サンプルに反射したp偏光とs偏光間の位相を測定することで、測定する光の波長(500nm)が、膜の厚さ(0.1nm未満)に比べて非常に長くても、サブモノレイヤーの厚さに至るまで正確な膜の厚さの定量値を提供します。
FS-1はMulti-Wavelength Ellipsometer技術により、膜厚計測において、厚さ0~1,000nmの範囲で繰返し精度(Precision) 0.01nm以下を達成することができます。膜厚が0~1000nmである単層の薄膜を対象とした、膜厚と屈折率の測定に優れています。
下表は、様々なサンプル(マルチ・レイヤーを含む)を用いたFS-1の標準測定での正確性(Accuracy)と精度(Precision)を示しています。


● in situでリアルタイム計測を実現
● エピタキシャル成長、堆積膜の膜厚定量
● 10m秒の高速でリアルタイム計測
● 蒸着率と薄膜の光学定数を計測
FS-1はALDやスパッタなど、様々な真空蒸着装置に取り付け、サンプル上の成膜過程をリアルタイムに計測可能です。エピタキシャル成長膜だけではなく、従来のRHEED(反射高速電子回折)では困難だった堆積膜の膜厚を定量可能です。その測定スピードは最速10m秒で膜厚変化を計測可能です。上の画像は、スパッタ装置に取り付けた事例です。
FS-1はコンフラット真空フランジに接続可能で、真空蒸着装置に接続することができます。真空を破らず、膜厚計測だけではなく蒸着率と薄膜の光学定数(n/k値)を特定することができます。またFS-APIインターフェース(LabVIEW™ 互換性あり)で外部ソフトウェア制御ができます。

原子層堆積装置(ALD)は、化学反応による成膜方法で、原子一層の成膜を行う装置です。 原子一層レベル(nmもしくはÅ領域)での成膜コントロールができます。
FS-1では高い膜厚精度(厚さ0~1000nmの範囲で膜厚精度0.001nm以上)で、成膜過程をin situでリアルタイムに高精度計測することができます。
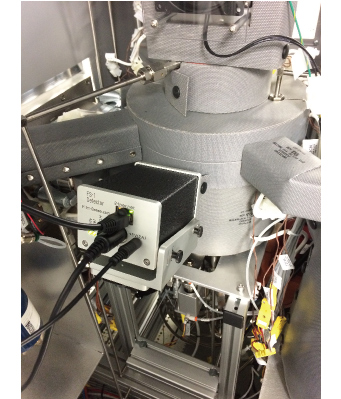
<ALD搭載事例>
Kurt J. Lesker社(モデルALD 150LX)、
Lam Research社、
Picosun社、
Beneq社、
Ultratech社、
その他、カスタムALDチャンバー
簡単操作で様々なサンプル測定が可能
通常は3つのモードで簡単に膜厚測定から解析・解析結果の検証ができます。
解析モードでは、エリプソメトリックデータの解析結果を可視化と数値化しますので簡単に解析評価が可能です。
また、光学データにより、解析結果の検証が可能になります。
様々なサンプル解析を
FS-1のソフトウェアには、様々な素材の光学定数ライブラリがインストールされています。Cauchy、Tauc-
Lorentz、Drudeモデルなどの誘電関数モデルも搭載されており、サンプルの光学特性に応じた解析が可能です。また、Bruggemanの有効媒質近似(EMA)を用いた、表面ラフネスや混合層の解析も可能で様々なサンプルを高精度に膜厚評価ができます。

シングル測定モードでは、サンプルセットした後、ワンクリックするだけで簡単にサンプルを測定できます。
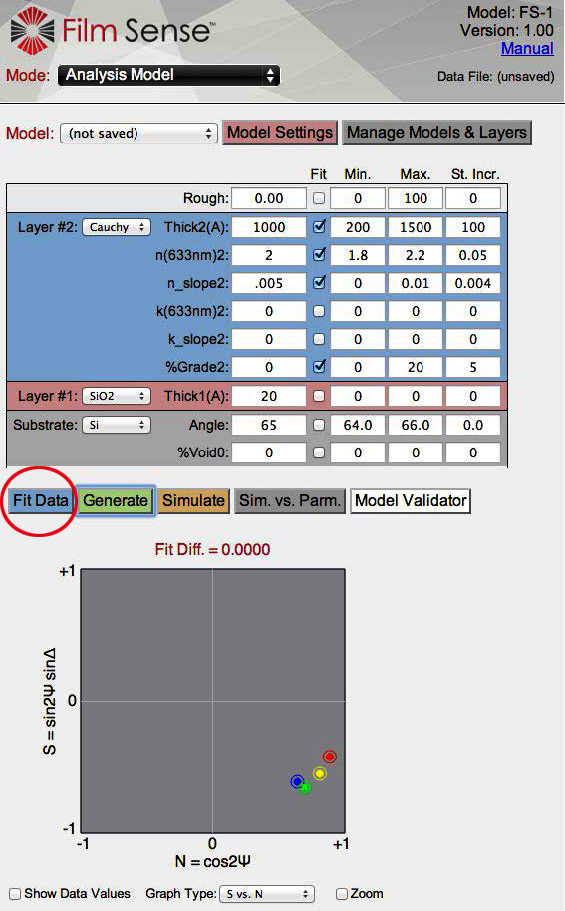
解析モデルモードでは、FS-1エリプソメトリック測定データを解析して視覚化するための強力な機能が提供されます。
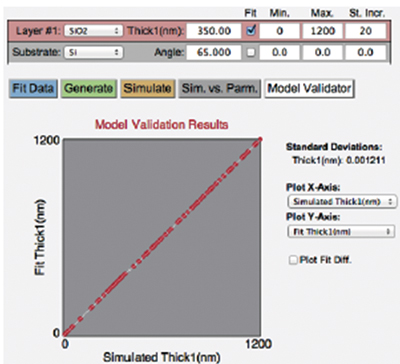
光学モデル検証ツールは、すべてのモデル適合パラメータが指定された範囲に一意に収束することを検証します。
FS-1は、サンプルの光学的特性を明らかにするために、エリプソメーター(偏光解析法)を用います。
エリプソメーターシステムでは、光状態発生装置(PSG)からサンプルに対して斜めに偏光と既知の偏光を放射し、サンプルからの反射光の偏光状態を偏光状態検出器(PSD)で検知し測定します。

サンプルからの反射による偏光状態の変化は、「サンプルからのS偏光反射率」分の「サンプルからのP偏光反射率」の割合によって明確にできます。この割合は複素数であり(一般的にρ[ロー]と表記される)、しばしばエリプソメトリックパラメータΨ[プサイ]やΔ[デルタ]と以下の数式で定義されているように記載されている。この数式によると、tan(Ψ)はP偏光とS偏光反射率の割合の大きさを定義しており、Δは反射したP偏光とS偏光の位相差を定義しています。

エリプソメトリックパラメータの別の表記は以下に記載されている通りです。Nや、C、Sのエリプソメトリックパラメータは、サンプルが当方的でありかつ非脱分極性であると仮定すると、ΨとΔのパラメータから算出することができます。N、C、Sと表記する利点は、サンプルが脱分極性であった場合、P偏光の度合いも記載できることです。
サンプルで測定された(さらにΨ/Δ または N,C,Sのどちらかの表記で記載された)エリプソメトリックパラメータにより、フィルムの厚さや光学定数といった、サンプルの興味深い特性を特定するため、より詳しい解析を行うことができます。
情報の内容増加
単純にサンプルからの反射光を測定する場合(サンプルからの反射光の光強度のみを測定)と比較すると、エリプソメトリック測定(偏光を活用した測定)ははるかに複雑となります。しかしながら、エリプソメトリックパラメーターに含まれる追加情報は、このエリプソメトリック測定の複雑さを相殺することができます。2つのエリプソメトリック値は、各波長で測定します。(P偏光の度数は3番目の値を提供することになります。)それに対し、反射光では1つの値しか測定されません。
ダイレクトな基板光学定数の判定
2つのエリプソメトリックパラメーター(ΨとΔ)の情報を直接活用する例として、基板の擬誘電関数<ε>の算出が挙げられます。誘電関数εは、物質の光学的性質評価の1つの方法であり、また、複素数値(実数部ε1と、虚数部ε2を含む)となります。さらに、誘電関数は複素屈折率ñの二乗(ñの実数部が屈折率n、ñの虚数部が消衰係数k)となります。測定されたサンプルに被覆層やラフネスがないと仮定すると、基板<ε>の擬誘電関数は、エリプソメーターで測定されたΨとΔの値から、以下の公式(パラメータθは、測定した光線の入射角)を使用することで算出が可能です。事前の仮定は常に厳密に満足できるものではないため、括弧「<>」で記載されているように、接頭語「擬~」が付与されます。

反射光のデータから、基板の誘電関数の実部数と虚数部(または同等の基板のnとk)を得るためには、データ解析と適切な分散モデルを兼ね備えた広大なスペクトル領域にわたる測定が必須となります。エリプソメトリックデータにより、基板の誘電関数(または同等のnとk)を直接算出することが可能です。
薄膜の厚さと屈折率の判定
エリプソメーターの利点である情報の保持を説明する例は、基板上の透過薄膜の厚さと屈折率の判定です。エリプソメーターは、2つのパラメータ(ΨとΔ)を測定するため、2つのサンプルが関連したパラメーターを直接判定することが可能です。この場合、膜dの厚さと膜の屈折率n1となります。これは、以下に記されているように、薄膜インターフェースの数式の数値を逆にすることで実施できます。この数式では、各インターフェースと膜の位相因子βでの反射係数rp,sは各媒体の屈折率や、入射角θ、フレネルの式、スネルの法則(FS-1ソフトウェアは、このようなすべての計算を内部的に制御しています)を用いて算出されます。

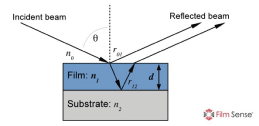
この分析では、厚さ10nm以下の薄膜の場合、いくつかの制限事項(膜の厚さと屈折率との相関関係による)がありますが、エリプソメーターは厚さ25nm以下の薄膜の屈折率を判定することにおいて、リフレクトメトリー(反射率計法)に比べ優れています。他にも、制限事項が発生します。従来の単一波長エリプソメーターで薄膜の厚さを判定した場合、厚みの数値の倍数は薄膜の数式を満たすことはできるが、厚みの「周期性」問題を引き起こします。FS-1 Multi-Wavelength Ellipsometer技術では、波長を複数測定することにより、この周期性問題を排除しています。
光強度の非依存性
光学的な手法として、エリプソメーターは迅速で非破壊的です。また、研究室、現場、バキュームチャンバーの中、さらには液体環境など、幅広い環境での動作が可能です。エリプソメーター特有のアドバンテージは、測定したパラメーターが、測定時の光強度に依存しないことです。この利点は、エリプソメトリックパラメーターの定義が割合によることからきています。光線の強度に依存しない特性のエリプソメトリック測定は、一定の光強度を維持することが困難な状況で、とても有益です。たとえば、現場での測定や、高い安定性が必須となる長期間の測定です。またエリプソメーターは、様々なサンプルの非理想性(傷、ほこり、欠損、肉眼で確認できるラフネス)の影響を受けにくいです。このようなサンプルの非理想性は、測定する光線を分散させてしまい、分散した光線がエリプソメーターの偏光状態検出器(サンプルからの理想反射、正反射した光線のみ収集します)へは入りません。
資料請求などもこちらからどうぞ。お気軽にお問い合わせください。
資料請求などもこちらからどうぞ。
お気軽にお問い合わせください。